
High Purity/Ultra-High Purity Digital Thermal Mass High Flow Devices
Designed for semiconductor, MOVCD and other gas flow control applications that require a high purity all-metal flow path, the Brooks GF Series mass flow controllers deliver outstanding performance, reliability and flexibility. The GF101/121/126 extends the GF family to support flow rates up to 300 slpm N2 equivalent. The high flow design utilizes the proven GF sensor design and electronics as well as providing excellent flow stability to target high flow purge lines in CVD, LPCVD, Diffusion, Epi processes, semiconductor chamber clean processes and MOCVD purge flows.

Designed for high-flow applications like purge, the GF101/121/126 has all of the features and benefits of its predecessor, but with extended performance for flow rates up to 300 slpm. Compared with competitive products offering a similar flow rate, the compact footprint allows users to design smaller, more efficient systems. It also provides better actual process gas accuracty over devices that use traditional single point conversion factors when switching to a new gas. This series features an all metal seal flow path for durability and high leak integrity, precise, stable flow control with fast Sub-1 second settling times and 1% of reading accuracty to ensure reliable flow measurement or control in demanding gas flow applications. Plus it achieves excellent internal to external leak integrity.
Built on a common platform and interface, the GF101/121/126 series now enables an entire system to use one product platform:
- Based on the same technology and design as the low flow GFs: same sensor, same electronics, same low power support
- Smaller footprint than competitive MFCs
- Handles flow rates up to 300 slpm
- Metal seal for durability and high leak integrity
- Proprietary sensor technology
- Precise flow control with fast sub-1 second settling time
- 1% of reading accuracy
- Corrosion-resistant Hastelloy C-22 sensor tube
Ultra Fast Response
This series delivers up to 3 times faster response and settling time compared to other MFCs, enabling:
- Improved wafer throughput by reducing nonproductive flow settling steps
- Critical etch processes requiring ultrafast 1-2 second etch steps
- Time-sensitive gas delivery steps in Atomic Layer Deposition
- Reduced diverted gas consumption and associated abatement costs
- For processes requiring a slow ramped gas turn-on or time critical transitions between flow rates

Advanced Thermal Flow Measurement Sensor
Brooks’ proprietary sensor technology combines:
- Improved signal to noise performance for improved accuracy at low setpoints
- Improved long-term stability through enhanced sensor manufacturing and burn in process
- Improved reproducibility at elevated temperatures through new isothermal packaging, onboard conditioning electronics with ambient temperature sensing and compensation
- Highly corrosion resistant Hastelloy C-22 sensor tube
- Optimized temperature profile for gases prone to thermal decomposition
- Unique orthogonal sensor mounting orientation: eliminates sensor drift caused by valve heating effects / eliminates thermal siphoning effects for the most common mounting orientations
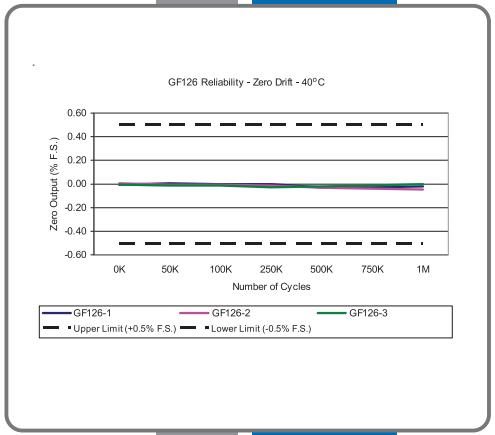
High Purity Flow Path
All metal, corrosion resistant flow path with reduced surface area and un-swept volumes for faster dry-down during purge steps:
- 4 µ inch Ra max surface finish standard (10 µ inch Ra on GF101/121/126)
- SEMI F-20 compliant wetted flow path
- Highly corrosion resistant Hastelloy C-22 valve seat and jet orifice

Extensive Mechanical Configuration Support
GF101/121/126 Series supports all metal seal / UHP industry gas connection interface standards for full OEM and process coverage
- 132.4 mm 4 VCR on 1.5″ body
Enhanced Diagnostics
The mass flow controller remains the most complex and critical component in gas delivery systems. When dealing with UHP gas distribution or highly toxic or corrosive gases, removing teh mass flow controller to determine if it is faulty should be the last resort. Brooks pioneered smarter mass flow controllers with embedded self test routines and introduced an independent diagnostic / service to provide the user with a simple interface for troubleshooting without disturbing flow controller operation.
User Interface
The user interface has a high visibility LCD display that provides a local indication of Flow (%), Temperature (°C), Pressure (PSIA/KPa) and Network Address, selectable through the Display button. A Zero button provides a simple means to re-zero the mass flow controller as part of scheduled maintenance. The display is rotatable with a push button to enable improved readability based on how the MFC is mounted.

Communication Interface
The GF101/121/126 Series supports analog 0-5 Vdc, RS485 and DeviceNet communication protocols. A range of low profile adapter cables facilitate replacing older mass flow controllers eliminating the need to carry mass flow contollers of the same gas/range but different electrical connectors.
Applications
Deposition Process
Chemical Vapor Deposition (CVD), the broadest family of processes, requires a diverse range of gases, precursors and flow rates. The GF101/121/126 Series platform has been selected by leading CVD Equipment OEMs requiring a mass flow controller capable of meeting their broad process requirements. This Series combines operating range (typical 3:1 programmability), process gas accuracy and low pressure drop/low temperature flow sensing to present the optimal feature-set for advanced CVD processing.

Thin Film – Semiconductor / Solar
Developed to meet the diverse process requirements in semiconductor, LED, vacuum thin film, solar and related industries, the GF101/121/126 Series is a single platform solution for advanced etch, chemical vapor deposition (CVD, PECVD, ALD, MOCVD), physical vapor deposition (PVD), rapid thermal processing (RTP), diffusion and other similar processes.
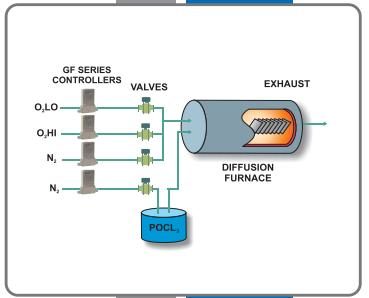
Purge
Atmospheric / purge gases are used for purging certain processing systems and equipment when a semiconductor manufacturer is concerned about possible back-contamination of the house purge lines. In addition, semiconductor integrated circuits are conventionally fabricated in clean rooms containing an atmosphere that is controlled to have a very low contamination content. The wafers are manufactured via chemical or other processes, and at times are very sensitive to oxygen and humidity and other volatile contaminants. In order to avoid the potential damage to the material in process, the GF101/121/126 Series MFCs are used in systems where the surrounding environment of the wafers and/or reticles are purged with a clean inert gas like nitrogen or clean dry air.









